焊点缺陷是SMT贴片加工中最常见、也最能直接拉低直通率与可靠性的“隐形杀手”。据统计,回流焊环节产生的缺陷占整个PCBA不良60%以上,其中焊点问题又占回流焊缺陷的80%。1943科技分享产线大数据,将焊点缺陷归纳为五大典型类型,并给出可立刻落地的工艺参数与设备管理方案,帮助电子制造同行快速降低返修率、提升交付口碑。
一、虚焊(Insufficient Solder)
1. 产生机理
焊膏印刷量不足、助焊剂活性降低或回流区峰值温度偏低,导致焊料未与焊盘/引脚形成有效冶金结合,出现“假连接”。
2. 关键诱因
- 钢网开孔面积小于焊盘80%,或厚度<0.10 mm,印刷量先天不足
- 焊膏回温时间<3 h、搅拌不均,金属含量降至85%以下,黏度下降
- 回流峰值低于焊料熔点15 ℃以上,液相线驻留<40 s,润湿不充分
3. 解决方案
- 钢网设计:开孔1:1.02扩出,厚度0.12–0.15 mm;细间距采用阶梯减薄+微倒角工艺
- 焊膏管控:2–8 ℃冷藏,上线回温≥4 h,自动搅拌机2 min,24 h内用完
- 温度曲线:Sn63Pb37峰值210–225 ℃,SAC305峰值235–245 ℃,液相线以上60–90 s
- 闭环检测:SPI每片测厚,低于-15%立即停机擦网;AOI+ICT双检,发现虚焊即时返修

二、桥连(Solder Bridge)
1. 产生机理
相邻焊盘间焊膏过量或熔化时表面张力失衡,形成横向锡桥,导致短路。
2. 关键诱因
- 钢网孔壁粗糙/开孔过大,印刷后焊膏塌陷
- 回流保温区温度过高(>180 ℃)、时间过长(>90 s),焊料流动性增强
- 贴片偏移>0.05 mm,元件引脚把焊膏挤出焊盘
3. 解决方案
- 开孔缩小10%,采用“倒锥”激光切割孔壁,降低塌陷风险
- 刮刀速度50–80 mm/s、压力0.02–0.03 MPa,保持45°角度,减少挖锡
- 优化保温区:160–180 ℃、60–80 s,让助焊剂充分挥发又不过度液化
- AOI在线报警+激光标记,桥连板立即隔离,热风刀局部返修

三、立碑(Tombstoning)
1. 产生机理
片式元件两端润湿力不平衡,产生力矩把元件一端拉起,形成“墓碑”。
2. 关键诱因
- 焊盘热容量差异大(一侧接地或铺铜)
- 两焊盘印刷量差>20%,熔化时间不同步
- 回流温差>10 ℃,升温斜率>3 ℃/s
3. 解决方案
- PCB设计:对称焊盘尺寸,差异≤10%;大铜面加“热隔离”窗或泪滴铺铜
- 钢网:0201/0402元件开孔0.8:1面积比,防锡量过多
- 回流曲线:预热1–2 ℃/s,恒温区150–180 ℃,峰值温差≤±5 ℃
- 贴片:Z轴高度0.05–0.10 mm,贴装压力20–30 g,确保居中
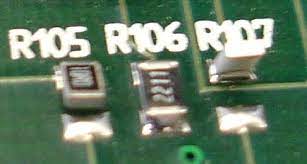
四、锡球(Solder Ball)
1. 产生机理
焊膏飞溅或助焊剂沸腾,在阻焊膜上形成直径>0.13 mm的独立锡珠,潜在短路风险。
2. 关键诱因
- 预热升温>4 ℃/s,水分/溶剂瞬间汽化
- 环境湿度>60%,焊膏吸潮
- 钢板底部未清洁,残留锡膏二次印刷被挤出
3. 解决方案
- 温区设置:预热斜率1–3 ℃/s,保温区保持150–180 ℃,让溶剂充分挥发
- 物料管理:开封后24 h内用完,湿度卡<30% RH,线边放置干燥柜
- 设备保养:每班擦拭钢板底部,5000片超声波清洗一次;增加真空吸锡装置
- AOI+人工目检双检,发现锡珠即用吸锡线+热风枪清理
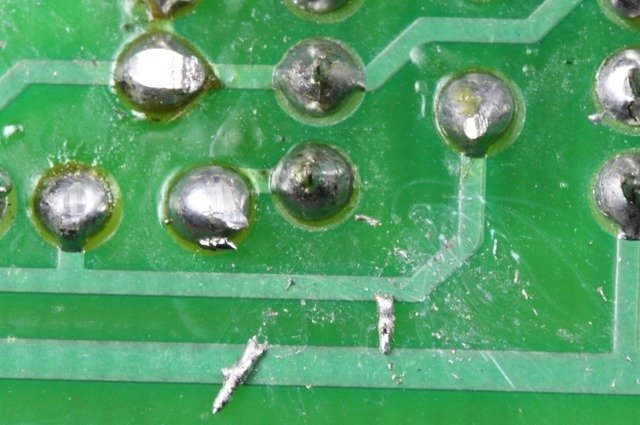
五、焊点剥离(Pad Lifting)
1. 产生机理
无铅合金与PCB基材热膨胀系数差异大,冷却阶段应力集中,焊点与焊盘界面发生微裂甚至剥离。
2. 关键诱因
- 冷却速率>6 ℃/s,应力瞬间增大
- 焊料合金非共晶,凝固区间宽
- 铜环面积过大,刚性增强
3. 解决方案
- 合金选型:SAC305或添加微量Bi/Ni,降低热膨胀差
- 冷却斜率:2–4 ℃/s,自然风冷+底部辅助冷却,避免急冷
- PCB设计:采用SMD焊盘,阻焊窗限制铜环面积;增加“应力释放”缝隙
- X-Ray抽检3%,空洞率>25%或发现剥离即整批返修,并回溯温度日志
结语
焊点缺陷并非孤立现象,而是“设计-物料-设备-工艺-环境”全链条交互的结果。1943科技通过“SPI+AOI+X-Ray”三维闭环检测与MES数据追溯,将上述五大缺陷总不良率稳定控制在≤0.05%。希望本文的五大原因与解决方案,能为您的SMT产线提供可直接复制的改善模板,携手把焊点做成“零缺陷”,把交付做成“零投诉”。








 2024-04-26
2024-04-26

